
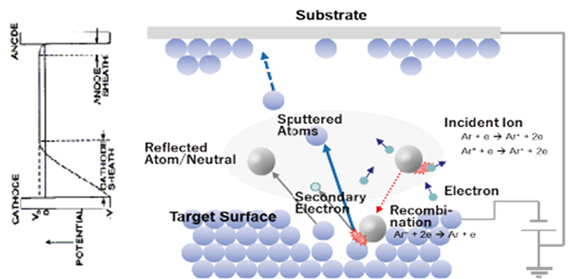
높은 에너지의 잔자방출 및 중성기체와 충돌·이온화
타게부근의 양의 Bias에 의한 이온가속 / Cathode Sheath를 거쳐 타겟과
충돌 · 운동량 전달 → 총 Bias(Vp-Vc) : 200 ~ 1000eV by I-V 특성
타겟의 격자이탈 및 기판으로 이동 : 3~10eV
이온의 타겟과의 충돌시 이차전자방출·자가방전유지
전자의 주위 기체와 충돌 Radical 및 음 이온생성 / Anode Sheath를 따라
가속기재 충격
방출된 타겟입자의 기재표면에 응축·박막형성


| Effective Width | 400m less then |
|---|---|
| Film Thickness | 25㎛ or more |
| Roll Diameter | 500m |
| Pretreatm ent | Plasma Pretreatm ent |
| Cathode | 1(Single)ea + 1(Dual)ea |
| Sputter Power | DC 1ea + MF 1Set |
| Heating System | IR-Heater / Drum |
| 증착유효폭 | 1500m |
|---|---|
| 필름두께 | 1500m |
| 필름롤직경 | 3000m |
| 장착필름길이 | 3000m |
| 필름길이 | < 5.0E-5Pa |
| 최대진공도 | < 5.0E-4Pa |
| 도달입력 | 플라즈마 처리(ea) |
| 스피터 장치 | 6(Single)ea+1(Dual)ea |
| 스피터 전원 | MF(1)ea / DC(6)ea |
| 기자가열장치 | IR히터 / Drum |
| 진공펌프 | Dry Pump+B |
| 포리콜드 | |
| 진공챔버 | 드럼 / 물 |
| 필름기재구동장치 | |
| 플라즈마 전처리 | |
| TMP / Cryo coil | |
| 스퍼터장치 | 캐소드 (듀얼) |
| 전원출력장치 | |
| 가스공급제어 |